科研动态

等离子体是物质的第四态。基于低温等离子体放电的物理/化学气相沉积(PVD/CVD)技术,则是目前制备各类先进功能薄膜与防护涂层材料的重要手段。高功率脉冲磁控溅射(HiPIMS)作为一种新型PVD技术,因其离化率高,且易于实现致密、光滑、大面积均匀的高质量薄膜制备,备受关注。过去几年来,中国科学院宁波材料技术与工程研究所的碳基薄膜材料技术团队,围绕HiPIMS涂层装备研制、等离子体放电分析、涂层应用验证等方面,开展了深入细致的研究。
首先,在中科院重大装备研制项目的资助下,团队通过对HiPIMS磁控源模块、电源模块(与哈工大合作)、真空-水-电-气路、PLC控制系统等的优化设计与加工集成,在国内较早研制出了自主产权的高功率脉冲磁控溅射复合镀膜装置。该装备等离子体放电稳定、金属离化率高、运行可靠。以金属Cr为例,HiPIMS的离化率高达50%(传统直流溅射<5%),等离子体密度为1.3E19/m3(比直流溅射高3-4数量级)。利用该装备,团队相继开展了HiPIMS制备非晶碳膜、MoS2润滑薄膜、氮基硬质涂层的研究【App. Surf. Sci. 283(2013)321,Surf. Coat. Technol. 228(2013)275,J. Mater. Sci. Technol. 31(2015)1193】,并将其拓展应用于硼基耐蚀涂层、MAX相氧化防护涂层,形成8项核心发明专利【例如201310026859.5, 2013100264796.7,201710546704.2,201911080939.2,201911165864.8】。
进一步对比国内外同行的研究,团队发现在实际应用中,HiPIMS因直流复合脉冲的高功率并不总能获得金属的高离化率【AIP Advances, 8(2018) 015132】。针对这一问题,团队建立了HiPIMS放电的数值模型,结合探针/光谱对等离子体原位诊断,分析了金属种类、二次电子发射系数、溅射产额、电离能对靶表面区电离过程的影响 【IEEE T Plasma Sci. 47 (2019) 1215】,提出了HiPIMS脉冲放电的四阶段特征。重要的是,发现在较高电压的HiPIMS辉光放电过程中,存在正常辉光向反常辉光的转变。这一结果说明,只有HiPIMS放电进入反常辉光区,才能实际获得金属的高离化【Phys. Plasmas, 24 (2017) 083507】。而且,即便对于难电离的非金属碳,调控脉冲宽度在反常辉光区,也能实现C的高离化率放电。
除了上述HiPIMS靶表面区域的放电特性理解,如何实现对近基体区域的等离子体定量分析(如活性粒子种类、离子密度、原子密度),则是影响涂层生长的另一放电基础内涵。虽然采用发射光谱仪(OES)可测量活性粒子种类,朗格缪尔探针可测量离子密度,但基态原子密度的准确测量目前非常困难。为此,团队通过对发射光谱仪的改造,实现了近基体表面区2 cm厚度内光发射信号的可靠采集。并基于提出的HIPIMS溅射级联碰撞-辐射跃迁的修正模型,准确计算出了等离子体中的基态金属原子密度。发现增加HiPIMS的脉冲电压,能有效降低沉积区内的金属原子含量并显著提高离子含量,实现不同溅射模式的转变,这是获得HiPIMS高离化率放电并进而实现涂层精细结构调控的关键。相关成果近期发表于英国皇家物理学会(IOP)旗下的等离子体科学领域Top期刊上【Plasma Sources Science and Technology, 29 (2020) 015013】。
上述研究工作得到了国家自然科学基金(51875555,11705258)、中国科学院先导专项(XDA22010303)、中科院王宽诚率先人才计划、及宁波市2025专项(2018B10012)等项目的资助。

HiPIMS不具有本征高离化率,相同条件下不同元素离化率差异显著

HiPIMS脉冲放电的四阶段特征以及正常辉光向反常辉光的转变
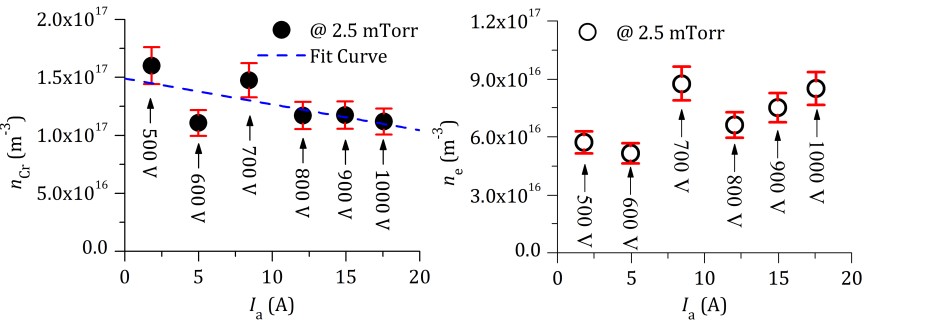
以Cr为例,随脉冲偏压增加,原子密度降低但离子密度增加

不同类型溅射模式的沉积示意图
打印本文本
加入收藏夹
回到顶部

地址:浙江省宁波市镇海区庄市大道319号
邮件:chenrd@nimte.ac.cn
电话:0574-86685036
